如今计算机的“心”奔腾不止,以百兆为单位高速提升,让我们不得不感叹CPU技术的成熟和完善。不过,光有一颗高速的芯好像还远远不够,为了让计算机真正快速地跑起来,整个内外系统都需要齐齐跟进,而内存则一向是一个关注焦点。如同微处理器一样,内存条的技术也是不断地更新。大家可能已发现手中内存条上的颗粒模样渐渐在变,变得比以前更小、更精致。变化不仅在表面上,这些新型的芯片在适用频率和电气特性上比老前辈也有了长足的进步。这一结晶应归功于那些厂商选用了新型内存芯片封装技术。
与CPU一样,在内存制造工艺流程上的最后一步也是最关键一步就是内存的封装技术。采用不同封装技术的内存条,在性能上会存在较大差距。从DIP、TSOP到BGA,不断发展的封装技术使得内存向着高频、高速的目标不断迈进。随着新一代CSP内存等新型技术的出现,意味着内存封装已经进入到CSP时代。
内存封装,“品质”外衣
封装技术其实就是一种将集成电路打包的技术。拿我们常见的内存来说,我们实际看到的体积和外观并不是真正的内存的大小和面貌,而是内存芯片经过打包即封装后的产品。这种打包对于芯片来说是必须的,也是至关重要的。因为芯片必须与外界隔离,以防止空气中的杂质对芯片电路的腐蚀而造成性能下降或损害。
另一方面,封装后的芯片也更便于安装和运输。由于封装技术的好坏还直接影响到芯片自身性能的发挥和与之连接的PCB(印刷电路板)的设计和制造,因此它又是至关重要的。
封装也可以说是指安装半导体集成电路芯片用的外壳,它不仅起着安放、固定、密封、保护芯片和增强导热性能的作用,而且还是沟通芯片内部世界与外部电路的桥梁——芯片上的接点用导线连接到封装外壳的引脚上,这些引脚又通过印刷电路板上的导线与其他器件建立连接。因此,对于很多集成电路产品而言,封装技术都是非常关键的一环。
从DIP封装到BGA封装
芯片的封装技术已经历经好几代的变迁,技术指标一代比一代先进,包括芯片面积与封装面积之比越来越接近,适用频率越来越高,耐温性能越来越好,以及引脚数增多,引脚间距减小,重量减小,可靠性提高,使用更加方便等等,都是看得见的变化。20世纪70年代时,芯片封装流行的还是双列直插封装,简称DIP(Dual ln-line Package)。DIP封装在当时具有适合PCB(印刷电路板)的穿孔安装。比TO型封装易于对PCB布线以及操作较为方便等一些特点。

采用TSOP封装技术的芯片
到了80年代出现的内存第二代封装技术以TSOP为代表,它很快为业界所普遍采用,到目前为止还保持着内存封装的主流地位。TSOP是英文Thin Small Outline Package的缩写,意即薄型小尺寸封装。TSOP内存封装技术的一个典型特征就是在封装芯片的周围做出引脚,如SDRAM内存的集成电路两侧都有引脚,SGRAM内存的集成电路四面都有引脚。TSOP适合用SMT技术(表面安装技术)在PCB(印刷电路板)上安装布线。TSOP封装时,寄生参数(电流大幅度变化时,引起输出电压扰动) 减小,适合高频应用,操作比较方便,可靠性也比较高。
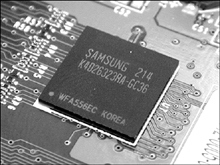
采用BGA封装技术的芯片
20世纪90年代随着集成技术的进步、设备的改进和深亚微米技术的使用,LSI、VLSI、ULSI相继出现,芯片集成度不断提高,I / O引脚数急剧增加,功耗也随之增大,对集成电路封装的要求也更加严格。为满足发展的需要,在原有封装方式的基础上,又增添了新的方式——球栅阵列封装,简称BGA(Ball Grid Array Package)。BGA 封装技术有这样一些特点:I / O引脚数虽然增多,但引脚间距并不小,从而提高了组装成品率。虽然它的功耗增加,但BGA能用可控塌陷芯片法焊接,从而可以改善它的电热性能。厚度和重量都较以前的封装技术有所减少。寄生参数减小,信号传输延迟小,使用频率大大提高。组装可用共面焊接,可靠性高。采用BGA新技术封装的内存,可以使所有计算机中的DRAM内存在体积不变的情况下内存容量提高两到三倍,BGA与TSOP相比,具有更小的体积、更好的散热性能和电性能。BGA封装技术使每平方英寸的存储量有了很大提升,采用BGA封装技术的内存产品在相同容量下,体积只有TSOP封装的三分之一。另外,与传统TSOP封装方式相比,BGA封装方式有更加快速和有效的散热途径。不过BGA封装仍然存在着占用基板面积较大的问题。

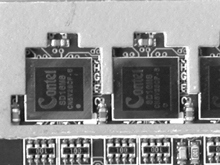
采用CSP封装技术的芯片
CSP新一代的内存封装技术
在BGA技术开始推广的同时,另外一种从BGA发展来的CSP封装技术正在逐渐展现它生力军本色。
CSP,全称为Chip Scale Package,即芯片级封装的意思。作为新一代的芯片封装技术,在BGA、TSOP的基础上,CSP的性能又有了很大的提升。
CSP封装可以让芯片面积与封装面积之比超过1:1.14,已经相当接近1:1的理想情况,绝对尺寸也仅有32平方毫米,约为普通的BGA的1/3,仅仅相当于TSOP内存芯片面积的1/6。这样在相同体积下,内存条可以装入更多的芯片,从而增大单条容量。也就是说,与BGA封装相比,同等空间下CSP封装可以将存储容量提高三倍。CSP封装内存不但体积小,同时也更薄,其金属基板到散热体的最有效散热路径仅有0.2mm,大大提高了内存芯片在长时间运行时的可靠性,线路阻抗显著减小,芯片速度也随之得到大幅度的提高。
不少国际DRAM大厂商都表示,虽然目前DDR266或DDR200很多还采用TSOP封装技术,但自DDR333开始,如再使用传统SDRAM的TSOP封装的话,在量产良品率上势必会出现极大问题,因此如需将规格向上提高到DDR333,则需将封装方式改用为CSP封装才有机会。据了解,目前DRAM颗粒厂如采用0.175微米工艺来制造DDR333颗粒,良品率上最多仅能达到20%(原因在于0.175微米工艺是用来制造DDR266),但如将工艺提升至0.15微米甚至0.13微米,用来制造DDR333颗粒,其良品率将可高达70%~80%。对于DRAM颗粒厂商而言,在制造一颗DDR266与DDR333时所耗费成本几乎是相差不大,因此使用CSP封装的高性能内存是大势所趋。
CSP的SDRAM模块,应用了倒装焊技术,与相同的模块空间TSOP封装比,它可以很容易地将内存容量增加为四倍以上。CSP的电气性能和可靠性也相比BGA、TOSP有相当的提高。在相同的芯片面积下CSP所能达到的引脚数明显地要比TSOP、BGA引脚数多得多(TSOP最多304根,BGA以600根为限,CSP原则上制造1000根都不难),这样它可支持I/O端口的数就增加了很多。
此外, CSP封装内存芯片的中心引脚形式有效地缩短了信号的传导距离,其衰减随之减少,芯片的抗干扰、抗噪性能也能得到大幅提升,这也使得CSP的存取时间比BGA改善15%-20%。在CSP的封装方式中,内存颗粒是通过一个个锡球焊接在PCB板上,由于焊点和PCB板的接触面积较大,所以内存芯片在运行中所产生的热量可以很容易地传导到PCB板上并散发出去。而传统的TSOP封装方式中,内存芯片是通过芯片引脚焊在PCB板上的,焊点和PCB板的接触面积较小,使得芯片向PCB板传热就相对困难。CSP封装可以从背面散热,且热效率良好,CSP的热阻为35℃/W,而TSOP热阻40℃/W。测试结果显示,运用Micro-CSP封装的内存可使传导到PCB板上的热量高达88.4%,而TSOP内存中传导到PCB板上的热量为71.3%。另外由于CSP芯片结构紧凑,电路冗余度低,因此它也省去了很多不必要的电功率消耗,致使芯片耗电量和工作温度相对降低。
随着以CPU为主的计算机系统性能的总体大幅度提升趋势,人们对于内存的品质和性能要求也日趋苛刻。为此,人们要求内存封装更加精致,以适应大容量的内存芯片,同时也要求内存封装的散热性能更好,以适应越来越快的核心频率。毫无疑问的是,进展不太大的TSOP等内存封装技术也越来越不适用于高频、高速的新一代内存的封装需求,新的CSP内存封装技术让我们看到了未来的方向。

